
Hệ thống showroom
01 KCCSHOP – HÀ NỘI
Địa chỉ: Số 1 phố Yên Lãng, Trung Liệt, Đống Đa, Hà Nội
Kinh Doanh: 0912.074.444
Bảo Hành: 0566.578.555
Khiếu Nại Dịch Vụ: 0886.886.365
Open: 08H30 - 21H00 hàng ngày
02 KCCSHOP – HỒ CHÍ MINH
Địa chỉ: 8B Lý Thường Kiệt, Phường 12, Quận 5, TP.HCM
Kinh Doanh: 0966.666.308
Bảo Hành: 0966.666.308
Khiếu Nại Dịch Vụ: 0886.886.365
Open: 08H30 - 21H hàng ngày
Bán hàng trực tuyến
01 PHÒNG KINH DOANH
02 HỖ TRỢ KĨ THUẬT, BẢO HÀNH
03 ĐƯỜNG DÂY NÓNG PHẢN ÁNH DỊCH VỤ
-

Bộ PC
![Thumb category]() a
a -

Laptop
![Thumb category]() a
a -

Thiết bị gia dụng
![Thumb category]() a
a -

MAIN
![Thumb category]() a
a -

CPU
![Thumb category]() a
a -

RAM
![Thumb category]() a
a -

VGA
![Thumb category]() a
a -

Ổ cứng
![Thumb category]() a
a -

Case
![Thumb category]() a
a -

Màn hình
![Thumb category]() a
a -

Gaming Gear
![Thumb category]() a
a -

Tản Nhiệt
![Thumb category]() a
a -

Hàng Thanh Lý
![Thumb category]() a
a
Công nghệ này sẽ được ra mắt trước HBM4 vào giai đoạn 2025/26. Việc giới thiệu các dịch vụ đóng gói 3D cho HBM trong năm nay sẽ đặt nền móng cho việc tích hợp HBM4 sau này, đánh dấu một bước tiến quan trọng trong lĩnh vực công nghệ bộ nhớ.
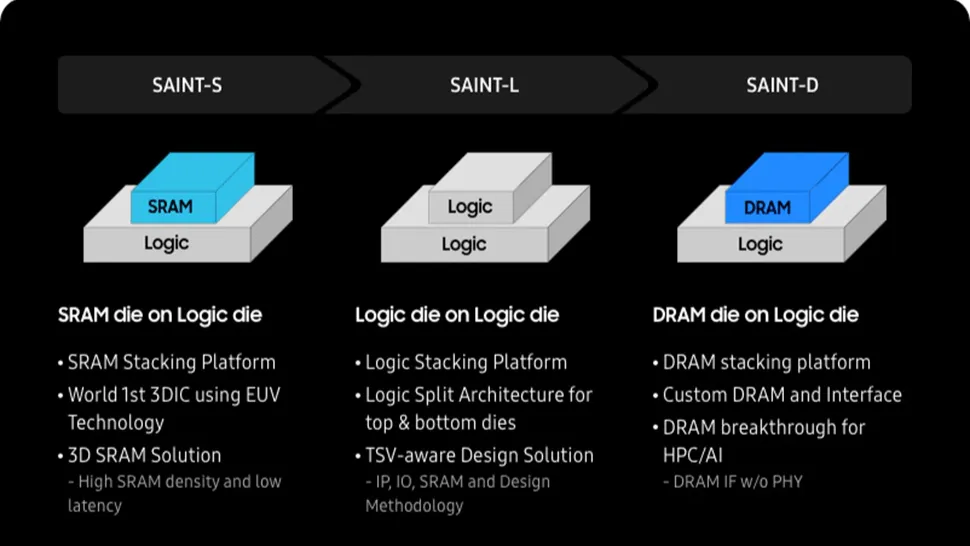
Samsung dự kiến sẽ giới thiệu dịch vụ đóng gói 3D cho bộ nhớ băng thông cao (HBM) trong năm nay, theo một báo cáo từ Korea Economic Daily trích dẫn thông báo của công ty tại Diễn đàn Samsung Foundry 2024 ở San Jose, cũng như từ 'các nguồn trong ngành.' Việc đóng gói 3D cho HBM chủ yếu mở đường cho việc tích hợp HBM4 vào cuối năm 2025 – 2026, nhưng chúng tôi không chắc chắn loại bộ nhớ nào Samsung sẽ đóng gói trong năm nay.
Đối với đóng gói 3D, Samsung có một nền tảng gọi là SAINT (Samsung Advanced Interconnect Technology) bao gồm ba công nghệ xếp chồng 3D khác nhau: SAINT-S cho SRAM, SAINT-L cho logic, và SAINT-D cho xếp chồng DRAM lên các chip logic như CPU hoặc GPU. Công ty đã làm việc trên SAINT-D trong nhiều năm (và chính thức công bố vào năm 2022) và có vẻ như công nghệ này sẽ sẵn sàng cho thời gian ra mắt chính thức trong năm nay, đánh dấu một cột mốc đáng chú ý cho nhà sản xuất bộ nhớ lớn nhất thế giới và một hãng đúc hàng đầu.
Phương pháp đóng gói 3D mới của Samsung bao gồm việc xếp chồng các chip HBM theo chiều dọc lên trên các bộ xử lý, khác với công nghệ 2.5D hiện tại kết nối các chip HBM và GPU theo chiều ngang qua một interposer silicon. Cách tiếp cận xếp chồng theo chiều dọc này loại bỏ sự cần thiết của interposer silicon nhưng yêu cầu một đế mới cho bộ nhớ HBM được sản xuất bằng công nghệ quy trình tiên tiến.
Công nghệ đóng gói 3D mang lại những lợi ích đáng kể cho HBM, bao gồm truyền dữ liệu nhanh hơn, tín hiệu sạch hơn, giảm tiêu thụ điện năng và giảm độ trễ, nhưng chi phí đóng gói tương đối cao. Samsung dự định cung cấp dịch vụ đóng gói 3D HBM tiên tiến này dưới dạng dịch vụ trọn gói, trong đó bộ phận kinh doanh bộ nhớ của họ sản xuất các chip HBM, và đơn vị foundry lắp ráp các bộ xử lý thực tế cho các công ty không sở hữu nhà máy sản xuất.
Điều vẫn chưa rõ là chính xác Samsung dự định cung cấp gì với SAINT-D trong năm nay. Việc đặt HBM lên một chip logic đòi hỏi một thiết kế chip phù hợp và chúng tôi không biết về bất kỳ bộ xử lý nào từ các công ty nổi tiếng được thiết kế để chứa HBM ở trên và dự kiến ra mắt vào năm 2024 - nửa đầu năm 2025.

Nhìn về phía trước, Samsung đặt mục tiêu giới thiệu công nghệ tích hợp dị thể tất cả trong một vào năm 2027. Công nghệ tương lai này sẽ cho phép tích hợp hai lớp chip logic, bộ nhớ HBM (trên interposer), và thậm chí là các hệ thống quang học đồng đóng gói (CPOs).


-
Hotline: 0912.074.444 - 0968.389.444
Bán hàng trực tuyến 1
Điện thoại: 0912.074.444Bán hàng trực tuyến 2
Điện thoại: 052.33.12345Địa chỉ : 452 Trường Chinh, Khương Thượng, Đống Đa, Hà Nội
Địa chỉ : 8B Lý Thường Kiệt, Phường 12, Quận 5, TP.HCM
Thêm sản phẩm vào giỏ hàng thành công!
TIN TỨC VÀ KẾT NỐI
khuyến mãi từ Kccshop
Địa chỉ: Số 1 phố Yên Lãng, Trung Liệt, Đống Đa, Hà Nội
Kinh Doanh HN : 0912.074.444
Kinh Doanh Tạ Xuân Hải: 056.311.2345
Kinh Doanh Nguyễn Tuấn Anh: 058.318.7888
Kinh Doanh Trần Trung Quang: 056.557.8555
Kinh Doanh Trần Hải Long: 058.711.4666
Kinh Doanh Nguyễn Thị Nhung: 052.331.2345
Bảo Hành : 0888.129.444
Khiếu Nại Dịch Vụ : 0886.886.365 - 0563.112.345 - 0798.666.696
Mở cửa : 08H30 - 21H Hàng Ngày
Mở kho : 08H30 - 19H Hàng Ngày
Bảo hành : Sáng 8H30 - 12H00, Chiều 13H30 - 18H00 trừ Chủ Nhật
Địa chỉ: 199 Nguyễn Chí Thanh, phường Chợ Lớn, TP.HCM
Kinh Doanh Lương Văn Tuấn: 096.666.6308
Kinh Doanh Nguyễn Trần Đức Toàn: 092.996.6993
Kinh Doanh Nguyễn Phan Bảo Long: 056.987.5888
Kinh Doanh Lê Đình Thái: 058.945.7666
Kinh Doanh Trương Gia Bảo: 058.381.2345
Bảo Hành : 0566.578.555
Khiếu Nại Dịch Vụ : 0886.886.365 - 0563.112.345 - 0798.666.696
Mở cửa : 08H30 - 21H Hàng Ngày
Mở kho : 08H30 - 19H Hàng Ngày
Bảo hành : Sáng 8H30 - 12H00, Chiều 13H30 - 18H00 trừ Chủ Nhật